面对5G毫米波频段,天线的尺寸将被缩小到毫米级,如果按照波长的1/4计算则终端天线可以以约2.5mm的点阵形式存在于手机终端中,因此具备了在手机端实现类似于基站天线的Massive MIMO方案。
目前毫米波天线阵列的实现的方式可分为AoC (Antenna on Chip)、AiP (Antenna in Package,封装天线)两种。其中AoC天线将辐射原件直接集成到射频芯片栈的后端,该方案的优点在于,在一个面积仅几平方毫米的单一模块上,没有任何射频互连和射频与基带功能的相互集成。考虑到成本和性能,AoC技术更适用于较毫米波频段更高频率的太赫兹频段(300GHz-3000GHz)。
而AiP是基于封装材料与工艺,将天线与芯片集成在封装内,实现系统级无线功能的技术。AiP技术顺应了硅基半导体工艺集成度提高的趋势,兼顾了天线性能、成本及体积,代表着近年来天线技术的重大成就及5G毫米波频段终端天线的技术升级方向。
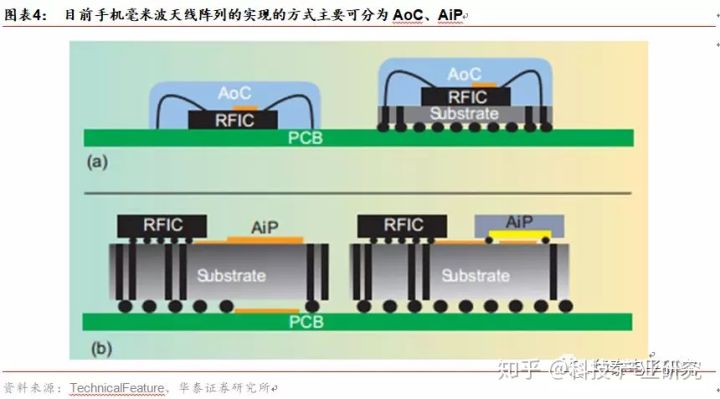
在2018年ISSCC(国际固态电路大会)上高通详细展示了其为5G移动终端及微基站开发的工作在28GHz频段的AiP产品。该方案集成了8个顶射双极化叠层微带天线、8个端射阵子天线以及2个芯片,形成一个相控阵。根据高通设计方案,将在手机终端上使用4个AiP,每一个AiP上的8个顶射双极化叠层微带天线阵及4个阵子都可以实现±45°快速波束扫描。
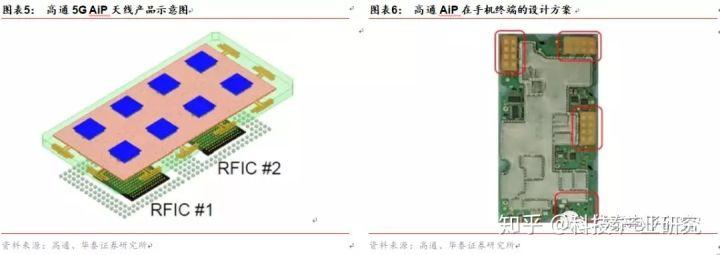
根据高通设计方案,微基站上需使用20个AiP,如下图所示,位于黑线框内的是有源天线、框外的则是无缘天线,有源部分相当于32x8个单元阵,形成2个32x4子阵,可实现双极化±60°快速波束扫描。
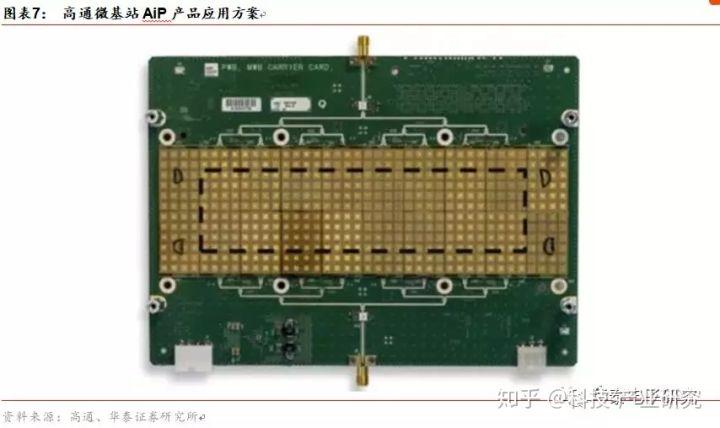
AiP天线由来已久,有望伴随5G 毫米波频段应用而发扬光大
AiP早期与蓝牙无线技术一起发芽,由于其继承发扬了微带天线、多芯片电路模块、瓦片式相控阵结构的集成概念,驱动了研究者自90年代末不断深入探索在芯片封装上集成单个或多个天线,这一阶段的研究工作主要集中在大学实验室,如何实现天线小型化是研究者所面临的主要问题。
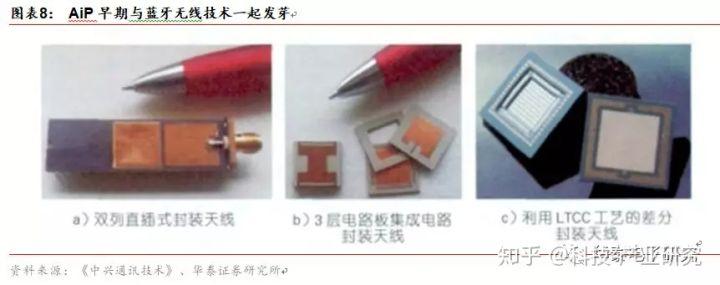
AiP中期与60GHz无线技术及毫米波雷达一起成长,开发主要集中在大公司。2010年IBM便公布了用于60GHz相控阵系统的完整AiP方案,该方案基于LTCC工艺将16个矩形微带天线集成在BGA封装中,发射或接收裸芯片通过倒装焊技术与AiP相连,之后IBM进一步将其AiP的工作频段推进到94GHz;2011年、2012年三星、Intel则分别发布了用于60GHz的相控阵系统AiP方案,同样基于LTCC与BGA工艺;2015年谷歌首次推出了使用60GHz信号快速追踪人手移动的手势雷达。如今几乎所有的60GHz无线通信和手势雷达芯片都采用了AiP技术。
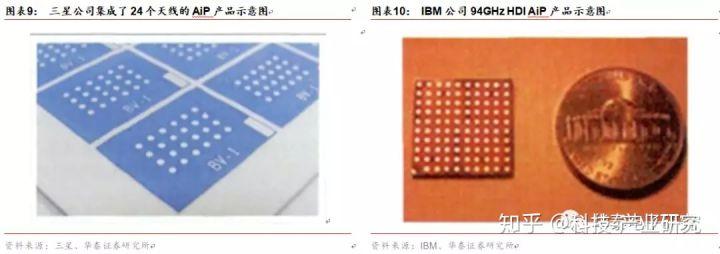
AiP是国际上5G移动通信研发的重要课题,难点是如何实现高辐射效率及低成本量产。2017年IBM推出的应用于5G基站的28GHz AiP,该方案包含4个单片SiGe裸芯片和64个双极化天线,尺寸约为7.1x7.1㎝²;同样在2017年高通发布了用于5G NR的首款智能手机毫米波芯片,尺寸约为5美分。

AiP工艺主要有LTCC、HDI及FOWLP三种方案
AiP工艺主要有LTCC(低温共烧结陶瓷)、HDI(高密度互联)及FOWLP(晶圆级扇出式封装)三种方案。其中LTCC工艺是由IBM于20世纪70年代初为其大型计算机芯片封装而开发的,后来经过多家公司历经几十年的发展,已经相当成熟。
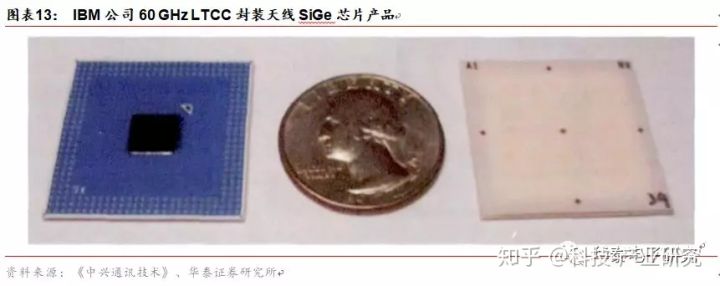
HDI工艺已经被很多公司用于开发毫米波AiP,图所示的是IBM公司所开发的基于HDI工艺的毫米波AiP剖面图,它由1个核心层与上下对称的各5个介质层以及6个金属层相互叠加而成,厚度为1.61mm。相比之下,LG公司开发的AiP由1个核心层与上下对称的各4个介质层及4个金属层相互叠加而成,厚度为0.8mm;高通公司的AiP则由1个核心层与上下对称的各3个介质层及4个金属层相互叠加而成,厚度小于1.1mm。
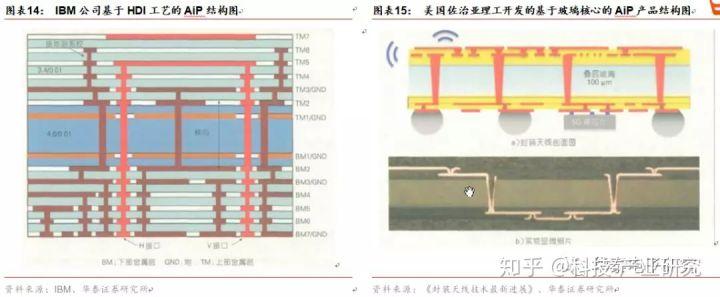
FOWLP工艺不同于LTCC或HDI工艺,FOWLP不再需要叠层基片,转而用模塑化合物、重新配置金属与介质层代替,基于FOWLP的AiP是由英飞凌公司研发的eWLB(嵌入式晶圆级封装)工艺发展而来。eWLB是将裸芯片嵌入在厚度为470μm的模塑化合物中。在裸芯片的扇入区以及封装的扇出区涂有介质层D1起到保护裸芯片的作用,D1层的厚度通常为6.5μm。重新配置的导体层(RDL)是沉积厚度为7.5μm的铜,用于实现连接线或天线。
由于eWLB工艺仅有1层金属,不利于实现基于FOWLP的AiP,为此,台积电开发出InFO-AiP技术,通过在模塑化合物上增加一层金属,微带天线辐射片由模塑化合物上面增加的金属层实现,微带天线地、馈线及耦合槽则在RDL金属层实现。
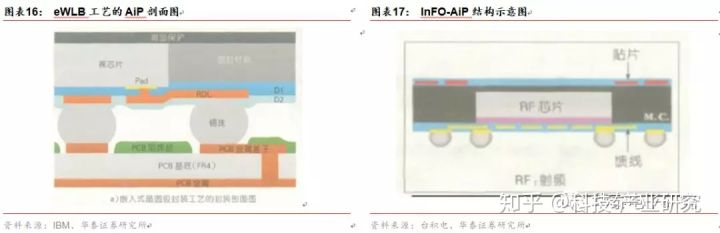
AiP对天线厂商提出了更高技术要求,行业面临重新洗牌
由以上AiP的发展历程及工艺路径可见,半导体封装材料与工艺是实现AiP技术的基础,测试是验证AiP性能是否达标的必要手段。目前AiP技术的开发主要集中在诸如高通及海思等芯片设计公司、台积电及三星等半导体集成电路制造公司、日月光及矽品等封装测试厂家。对传统的通信、3C天线公司而言提出了更全面、更高标准的技术挑战,基于各厂商的技术布局及进展,我们继续推荐拥有先进半导体封装工艺积累的天线厂商硕贝德以及在响应苹果创新过程中积累了多元的精密加工、制造能力,具备突出技术外溢特征的立讯精密。
在5G射频前端模组方面,经过多年的投入,硕贝德现已实现了从24GHz到43GHz全频段覆盖的技术突破,根据Cision讯,硕贝德开发的24GHz到43GHz全频段覆盖的射频前端模组产品于2018年6月IEEE举办的国际微波技术展览会(IMS)上成功展出。根据2018年8月公司在投资者互动平台的说明,其5G毫米波射频前端模组产品已与全球前三大的部份手机厂商进行深度战略合作。